Depositio strati atomici (ALD) est depositio technologiae chemicae vapor, quae membranae graciles iacuit per stratum crescens alternatim moleculis duobus vel pluribus praecursoribus injiciendo. ALD commoda altae moderabilitatis et uniformitatis habet, ac late in machinis semiconductoribus, machinationibus optoelectronicis, energiae machinis aliisque campis repositis, adhiberi potest. Principia ALD includunt praecursorem adsorptionem, reactionem superficiei et remotionem productivam, et multi- strati materiae repetendo hos gradus in cyclo formari possunt. ALD characteres et utilitates magnae moderabilitatis, uniformitatis, et non-rarum structurae habet et adhiberi potest pro depositione variae materiae subiectae et variarum materiarum.
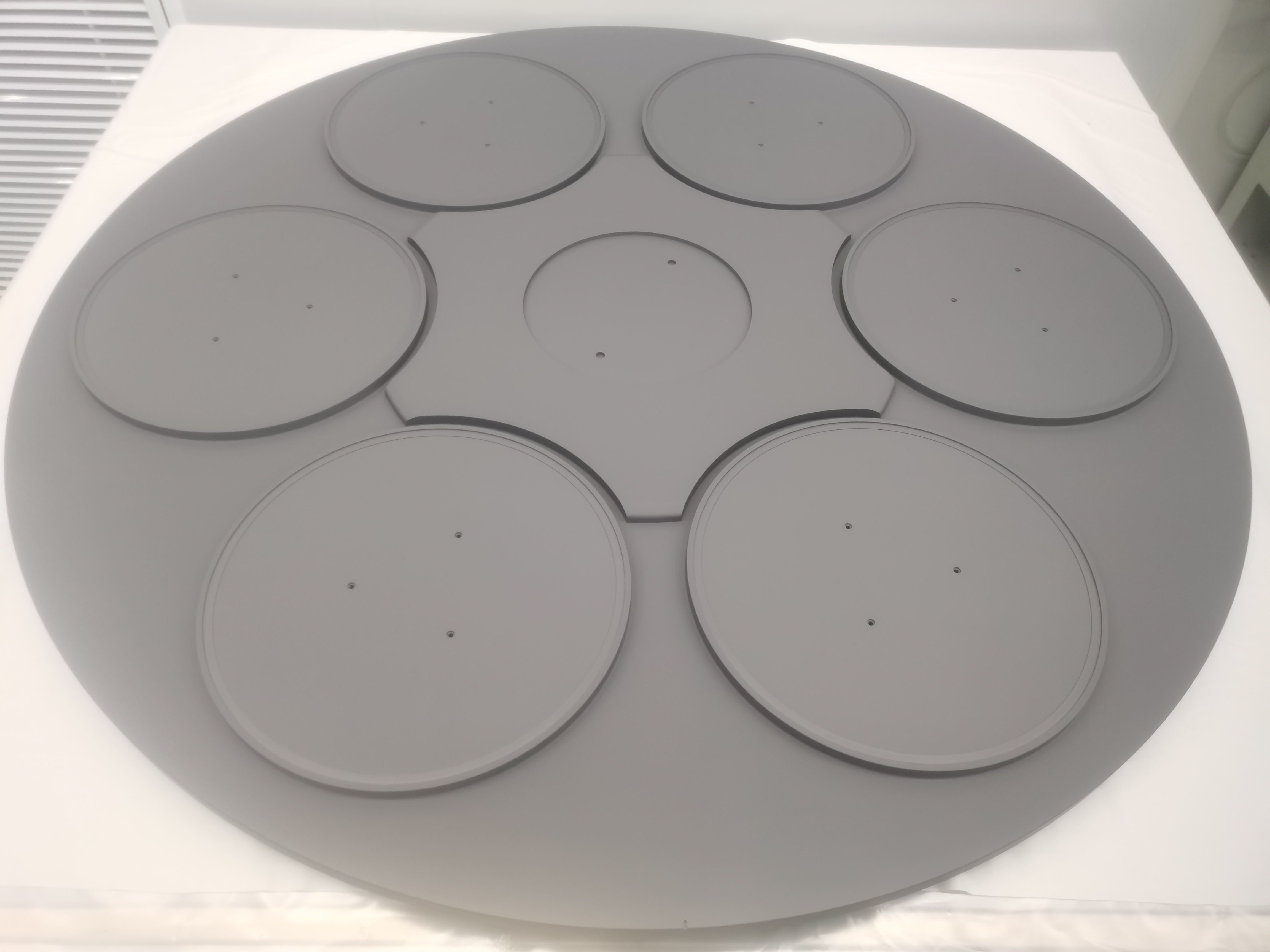
ALD habet notas et utilitates;
1. High controllability:Cum ALD sit processus incrementi iacuit, crassitudo et compositio uniuscuiusque materiae accumsan praecise temperari potest.
2. Uniformitas;ALD in tota superficie subiecta materiae uniformiter deponere potest, vitans inaequalitatem quae in aliis technologiarum depositionibus fieri potest.
3. Non-rarum;Cum ALD in unitatibus atomorum singularium vel moleculis singularibus deponitur, cinematographica plerumque densam, non raram structuram habet.
4. Bene coverage perficientur:ALD potest efficaciter operire structuras rationis aspectum altam, ut nanopore vestit, materiam porositatem altam, etc.
5. Scalability:ALD adhiberi potest pro variis materiis subiectorum, incluso metallis, semiconductoribus, vitro, etc.
6. Versatility:Moleculae praecursoris diversae eligendo, variae materiae diversae in processu ALD deponi possunt, ut oxydi metalli, sulfides, nitrides, etc.